
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ວິທີການ Debonding ຕົ້ນຕໍ
ດ້ວຍຄວາມກ້າວຫນ້າຂອງການປຸງແຕ່ງ semiconductor ແລະຄວາມຕ້ອງການທີ່ເພີ່ມຂຶ້ນສໍາລັບອົງປະກອບເອເລັກໂຕຣນິກ, ການນໍາໃຊ້ wafers ultra-thin (ຄວາມຫນາຫນ້ອຍກວ່າ 100 micrometers) ໄດ້ກາຍເປັນຄວາມສໍາຄັນເພີ່ມຂຶ້ນ. ຢ່າງໃດກໍຕາມ, ດ້ວຍການຫຼຸດຜ່ອນຄວາມຫນາຂອງ wafer ຢ່າງຕໍ່ເນື່ອງ, wafers ມີຄວາມສ່ຽງສູງທີ່ຈະແຕກຫັກໃນລະຫວ່າງຂະບວນການຕໍ່ມາ, ເຊັ່ນ: ການຂັດ, ການຂັດແລະການໂລຫະ.
ໂດຍທົ່ວໄປແລ້ວ ເທັກໂນໂລຍີການຜູກມັດ ແລະ ການເຊື່ອມໂຊມຊົ່ວຄາວ ແມ່ນນຳໃຊ້ເພື່ອຮັບປະກັນປະສິດທິພາບ ແລະ ຜົນຜະລິດທີ່ໝັ້ນຄົງຂອງອຸປະກອນ semiconductor. ແຜ່ນ wafer ທີ່ບາງທີ່ສຸດແມ່ນໄດ້ຖືກສ້ອມແຊມຊົ່ວຄາວໃສ່ແຜ່ນຍ່ອຍຂອງຜູ້ໃຫ້ບໍລິການທີ່ແຂງ, ແລະຫຼັງຈາກການປຸງແຕ່ງດ້ານຫລັງ, ທັງສອງໄດ້ຖືກແຍກອອກ. ຂະບວນການແຍກນີ້ເອີ້ນວ່າ debonding, ເຊິ່ງຕົ້ນຕໍປະກອບມີການ debonding ຄວາມຮ້ອນ, debonding laser, debonding ສານເຄມີ, ແລະ debonding ກົນຈັກ.
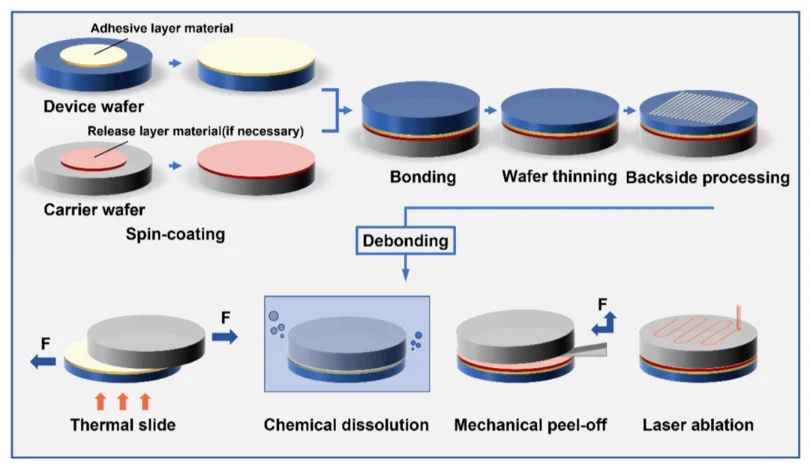
ການປົດປ່ອຍຄວາມຮ້ອນ
ການຖິ້ມຄວາມຮ້ອນແມ່ນວິທີການທີ່ແຍກ wafers ບາງໆອອກຈາກຊັ້ນຍ່ອຍຂອງຜູ້ໃຫ້ບໍລິການໂດຍການໃຫ້ຄວາມຮ້ອນເພື່ອເຮັດໃຫ້ກາວອ່ອນລົງແລະ decompose, ດັ່ງນັ້ນການສູນເສຍການຍຶດຕິດຂອງມັນ. ມັນແບ່ງອອກເປັນສ່ວນໃຫຍ່ເປັນສະໄລ້ຄວາມຮ້ອນ debonding ແລະ decomposition decomposition ຄວາມຮ້ອນ.
ການແຍກສະໄລ້ຄວາມຮ້ອນໂດຍປົກກະຕິແມ່ນກ່ຽວຂ້ອງກັບການໃຫ້ຄວາມຮ້ອນຂອງ wafers ທີ່ຜູກມັດກັບອຸນຫະພູມອ່ອນຂອງພວກມັນ, ເຊິ່ງຢູ່ລະຫວ່າງປະມານ 190 ° C ຫາ 220 ° C. ໃນອຸນຫະພູມນີ້, ກາວເຊື່ອມຈະສູນເສຍຄວາມຫນຽວຂອງມັນ, ແລະ wafers ບາງໆສາມາດຖືກຍູ້ຊ້າໆຫຼືປອກເປືອກອອກຈາກຊັ້ນຍ່ອຍຂອງຜູ້ໃຫ້ບໍລິການໂດຍແຮງຕັດທີ່ໃຊ້ໂດຍອຸປະກອນເຊັ່ນ:chucks ສູນຍາກາດເພື່ອບັນລຸການແຍກອອກເປັນກ້ຽງ. ໃນຂະນະທີ່ຢູ່ໃນການ decomposition decomposition ຄວາມຮ້ອນ, wafers ຜູກມັດໄດ້ຖືກໃຫ້ຄວາມຮ້ອນກັບອຸນຫະພູມທີ່ສູງຂຶ້ນ, ເຮັດໃຫ້ເກີດການ decomposition ສານເຄມີ (sission ລະບົບຕ່ອງໂສ້ໂມເລກຸນ) ຂອງກາວແລະສູນເສຍການຍຶດຫມັ້ນຂອງຕົນ. ດັ່ງນັ້ນ, wafers ທີ່ຖືກຜູກມັດສາມາດຖືກແຍກອອກຕາມທໍາມະຊາດໂດຍບໍ່ມີການບັງຄັບໃຊ້ກົນຈັກໃດໆ.
ການຕັດເລເຊີ
Laser debonding ແມ່ນວິທີການ debonding ທີ່ນໍາໃຊ້ irradiation laser ໃນຊັ້ນກາວຂອງ wafers ຜູກມັດ. ຊັ້ນກາວດູດເອົາພະລັງງານເລເຊີແລະສ້າງຄວາມຮ້ອນ, ດັ່ງນັ້ນຈຶ່ງດໍາເນີນການປະຕິກິລິຍາ photolytic. ວິທີການນີ້ເຮັດໃຫ້ສາມາດແຍກ wafers ບາງໆອອກຈາກຊັ້ນຍ່ອຍຂອງຜູ້ໃຫ້ບໍລິການຢູ່ໃນອຸນຫະພູມຫ້ອງຫຼືອຸນຫະພູມທີ່ຂ້ອນຂ້າງຕໍ່າ.
ຢ່າງໃດກໍຕາມ, ເງື່ອນໄຂເບື້ອງຕົ້ນທີ່ສໍາຄັນສໍາລັບການ debonding laser ແມ່ນວ່າ substrate ຜູ້ໃຫ້ບໍລິການຈະຕ້ອງມີຄວາມໂປ່ງໃສກັບຄວາມຍາວຂອງເລເຊີທີ່ໃຊ້. ດ້ວຍວິທີນີ້, ພະລັງງານເລເຊີສາມາດເຈາະເຂົ້າໄປໃນຊັ້ນຍ່ອຍຂອງຜູ້ໃຫ້ບໍລິການແລະຖືກດູດຊຶມຢ່າງມີປະສິດທິພາບໂດຍວັດສະດຸຊັ້ນຜູກມັດ. ດ້ວຍເຫດຜົນນີ້, ການເລືອກຄວາມຍາວຂອງເລເຊີແມ່ນມີຄວາມ ສຳ ຄັນຫຼາຍ. ຄວາມຍາວຂອງຄື້ນທົ່ວໄປປະກອບມີ 248 nm ແລະ 365 nm, ເຊິ່ງຄວນຈະຖືກຈັບຄູ່ກັບຄຸນລັກສະນະການດູດຊຶມ optical ຂອງອຸປະກອນການຜູກມັດ.
ການຫັກລົບທາງເຄມີ
Debonding ເຄມີບັນລຸການແຍກຕົວຂອງ wafers ຜູກມັດໂດຍການລະລາຍຊັ້ນຫນຽວທີ່ຜູກມັດດ້ວຍສານລະລາຍສານເຄມີທີ່ອຸທິດຕົນ. ຂະບວນການນີ້ຕ້ອງການໂມເລກຸນລະລາຍທີ່ເຈາະເຂົ້າໄປໃນຊັ້ນກາວເພື່ອເຮັດໃຫ້ເກີດການໃຄ່ບວມ, ມີຮອຍແຕກຂອງລະບົບຕ່ອງໂສ້, ແລະການລະລາຍໃນທີ່ສຸດ, ເຊິ່ງອະນຸຍາດໃຫ້ wafers ບາງໆແລະຊັ້ນຍ່ອຍຂອງຜູ້ໃຫ້ບໍລິການແຍກອອກຈາກທໍາມະຊາດ. ເພາະສະນັ້ນ, ບໍ່ມີອຸປະກອນຄວາມຮ້ອນເພີ່ມເຕີມຫຼືແຮງກົນຈັກທີ່ສະຫນອງໂດຍ chucks ສູນຍາກາດແມ່ນຈໍາເປັນ, debonding ສານເຄມີສ້າງຄວາມກົດດັນຫນ້ອຍສຸດ wafers.
ໃນວິທີການນີ້, wafers ຜູ້ໃຫ້ບໍລິການມັກຈະຖືກເຈາະລ່ວງຫນ້າເພື່ອໃຫ້ສານລະລາຍຕິດຕໍ່ຢ່າງເຕັມສ່ວນແລະລະລາຍຊັ້ນຜູກມັດ. ຄວາມຫນາຂອງກາວມີຜົນກະທົບຕໍ່ປະສິດທິພາບແລະຄວາມເປັນເອກະພາບຂອງການເຈາະແລະການລະລາຍຂອງສານລະລາຍ. ກາວເຊື່ອມທີ່ລະລາຍໄດ້ສ່ວນຫຼາຍແມ່ນເປັນວັດສະດຸທີ່ເຮັດດ້ວຍຄວາມຮ້ອນ ຫຼື ໂພລີອິມide ທີ່ຖືກດັດແປງ, ໂດຍປົກກະຕິແລ້ວແມ່ນໃຊ້ດ້ວຍການເຄືອບສະປິນ.
ການແກ້ໄຂກົນຈັກ
ການຖິ້ມຂີ້ເຫຍື້ອດ້ວຍກົນຈັກຈະແຍກ wafers ບາງໆອອກຈາກຊັ້ນຍ່ອຍຂອງຜູ້ໃຫ້ບໍລິການຊົ່ວຄາວເທົ່ານັ້ນໂດຍການໃຊ້ແຮງປອກເປືອກກົນຈັກທີ່ມີການຄວບຄຸມ, ໂດຍບໍ່ມີຄວາມຮ້ອນ, ສານລະລາຍສານເຄມີ, ຫຼືເລເຊີ. ຂະບວນການແມ່ນຄ້າຍຄືກັນກັບການປອກເປືອກ tape, ບ່ອນທີ່ wafer ຄ່ອຍໆ "ຍົກ" ໂດຍຜ່ານການດໍາເນີນງານກົນຈັກທີ່ຊັດເຈນ.
Semicorex ສະຫນອງຄຸນນະພາບສູງSIC Porous Ceramic Debonding Chucks. ຖ້າທ່ານມີຄໍາຖາມໃດໆຫຼືຕ້ອງການລາຍລະອຽດເພີ່ມເຕີມ, ກະລຸນາຢ່າລັງເລທີ່ຈະຕິດຕໍ່ກັບພວກເຮົາ.
ເບີໂທຕິດຕໍ່ #+86-13567891907
ອີເມວ: sales@semicorex.com




