
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe ໃນການຜະລິດຊິບ: ບົດລາຍງານຂ່າວທີ່ເປັນມືອາຊີບ
ວິວັດທະນາການຂອງວັດສະດຸ Semiconductor
ໃນໂລກຂອງເທກໂນໂລຍີ semiconductor ທີ່ທັນສະໄຫມ, ການຂັບເຄື່ອນທີ່ບໍ່ຢຸດຢັ້ງໄປສູ່ການຍ່ອຍສະຫຼາຍໄດ້ຊຸກຍູ້ຂອບເຂດຈໍາກັດຂອງວັດສະດຸທີ່ໃຊ້ຊິລິໂຄນແບບດັ້ງເດີມ. ເພື່ອຕອບສະຫນອງຄວາມຕ້ອງການປະສິດທິພາບສູງແລະການໃຊ້ພະລັງງານຕ່ໍາ, SiGe (Silicon Germanium) ໄດ້ອອກມາເປັນວັດສະດຸປະສົມຂອງທາງເລືອກໃນການຜະລິດຊິບ semiconductor ເນື່ອງຈາກຄຸນສົມບັດທາງກາຍະພາບແລະໄຟຟ້າທີ່ເປັນເອກະລັກ. ບົດຄວາມນີ້ delves ເຂົ້າໄປໃນຂະບວນການ epitaxyຂອງ SiGe ແລະບົດບາດຂອງມັນໃນການເຕີບໂຕຂອງ epitaxial, ການໃຊ້ຊິລິໂຄນທີ່ເຄັ່ງຄັດ, ແລະໂຄງສ້າງ Gate-All-Around (GAA).
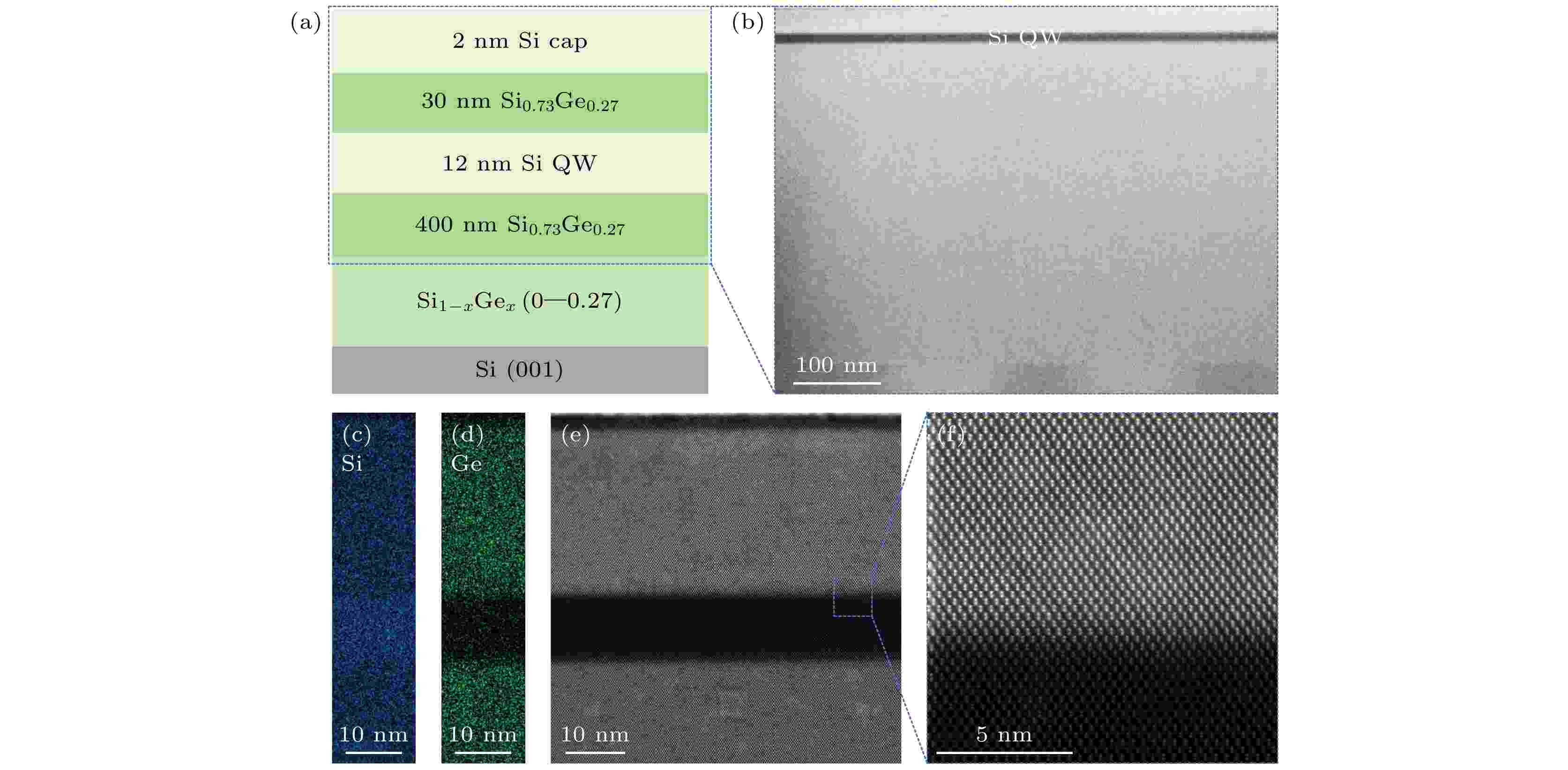
ຄວາມສໍາຄັນຂອງ SiGe Epitaxy
1.1 ການແນະນໍາ Epitaxy ໃນການຜະລິດຊິບ:
Epitaxy, ມັກຈະຫຍໍ້ເປັນ Epi, ຫມາຍເຖິງການເຕີບໃຫຍ່ຂອງຊັ້ນແກ້ວຊັ້ນດຽວໃນຊັ້ນໃຕ້ຂອງໄປເຊຍກັນດຽວທີ່ມີການຈັດວາງເສັ້ນດ່າງດຽວກັນ. ຊັ້ນນີ້ສາມາດເປັນໄດ້homoepitaxial (ເຊັ່ນ: Si/Si)ຫຼື heteroepitaxial (ເຊັ່ນ: SiGe/Si ຫຼື SiC/Si). ວິທີການຕ່າງໆແມ່ນໃຊ້ສໍາລັບການຂະຫຍາຍຕົວຂອງ epitaxial, ລວມທັງ Molecular Beam Epitaxy (MBE), Ultra-High Vacuum Chemical Vapor Deposition (UHV/CVD), Atmospheric and Reduced Pressure Epitaxy (ATM & RP Epi). ບົດຄວາມນີ້ໄດ້ສຸມໃສ່ຂະບວນການ epitaxy ຂອງຊິລິໂຄນ (Si) ແລະ silicon-germanium (SiGe) ຖືກນໍາໃຊ້ຢ່າງກວ້າງຂວາງໃນການຜະລິດວົງຈອນປະສົມປະສານ semiconductor ກັບຊິລິຄອນເປັນອຸປະກອນການ substrate.
1.2 ຂໍ້ໄດ້ປຽບຂອງ SiGe Epitaxy:
ການລວມເອົາອັດຕາສ່ວນທີ່ແນ່ນອນຂອງ germanium (Ge) ໃນລະຫວ່າງຂະບວນການ epitaxyປະກອບເປັນຊັ້ນກ້ອນດຽວ SiGe ທີ່ບໍ່ພຽງແຕ່ຫຼຸດຜ່ອນຄວາມກວ້າງ bandgap ແຕ່ຍັງເພີ່ມຄວາມຖີ່ຕັດຂອງ transistor (fT). ນີ້ເຮັດໃຫ້ມັນສາມາດໃຊ້ໄດ້ຢ່າງກວ້າງຂວາງໃນອຸປະກອນຄວາມຖີ່ສູງສໍາລັບການສື່ສານໄຮ້ສາຍແລະ optical. ຍິ່ງໄປກວ່ານັ້ນ, ໃນຂະບວນການວົງຈອນປະສົມປະສານ CMOS ກ້າວຫນ້າ, ຄວາມບໍ່ສອດຄ່ອງ lattice (ປະມານ 4%) ລະຫວ່າງ Ge ແລະ Si ແນະນໍາຄວາມກົດດັນ lattice, ເສີມຂະຫຍາຍການເຄື່ອນໄຫວຂອງເອເລັກໂຕຣນິກຫຼືຮູແລະດັ່ງນັ້ນຈຶ່ງເຮັດໃຫ້ອຸປະກອນການອີ່ມຕົວຂອງປະຈຸບັນແລະຄວາມໄວຕອບສະຫນອງ.
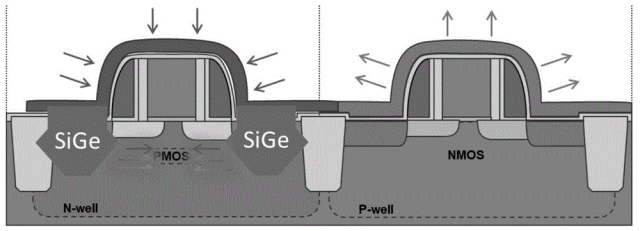
ຂະບວນການ SiGe Epitaxy ທີ່ສົມບູນແບບ
2.1 ການປິ່ນປົວກ່ອນ:
wafers ຊິລິໂຄນໄດ້ຖືກປະຕິບັດລ່ວງຫນ້າໂດຍອີງໃສ່ຜົນໄດ້ຮັບຂະບວນການທີ່ຕ້ອງການ, ຕົ້ນຕໍກ່ຽວຂ້ອງກັບການໂຍກຍ້າຍຂອງຊັ້ນ oxide ທໍາມະຊາດແລະ impurities ເທິງຫນ້າດິນ wafer. ສໍາລັບ wafers substrate doped ຢ່າງຫຼວງຫຼາຍ, ມັນເປັນສິ່ງສໍາຄັນທີ່ຈະພິຈາລະນາວ່າ backsealing ແມ່ນມີຄວາມຈໍາເປັນເພື່ອຫຼຸດຜ່ອນການ doping ອັດຕະໂນມັດໃນໄລຍະຕໍ່ມາ.ການຂະຫຍາຍຕົວ epitaxy.
2.2 ອາຍແກັສການຂະຫຍາຍຕົວ ແລະເງື່ອນໄຂ:
ອາຍແກັສຊິລິໂຄນ: Silane (SiH₄), Dichlorosilane (DCS, SiH₂Cl₂), ແລະ Trichlorosilane (TCS, SiHCl₃) ແມ່ນສາມແຫຼ່ງອາຍແກັສຊິລິຄອນທີ່ໃຊ້ທົ່ວໄປທີ່ສຸດ. SiH₄ ເຫມາະສໍາລັບຂະບວນການ epitaxy ເຕັມທີ່ອຸນຫະພູມຕ່ໍາ, ໃນຂະນະທີ່ TCS, ເປັນທີ່ຮູ້ຈັກສໍາລັບອັດຕາການຂະຫຍາຍຕົວຢ່າງໄວວາຂອງມັນ, ຖືກນໍາໃຊ້ຢ່າງກວ້າງຂວາງສໍາລັບການກະກຽມຂອງຫນາ.ຊິລິຄອນ epitaxyຊັ້ນ.
ອາຍແກັສ Germanium: Germane (GeH₄) ແມ່ນແຫຼ່ງຕົ້ນຕໍສໍາລັບການເພີ່ມ germanium, ໃຊ້ຮ່ວມກັບແຫຼ່ງຊິລິຄອນເພື່ອສ້າງເປັນໂລຫະປະສົມ SiGe.
epitaxy ການຄັດເລືອກ: ການຂະຫຍາຍຕົວເລືອກແມ່ນບັນລຸໄດ້ໂດຍການປັບອັດຕາພີ່ນ້ອງຂອງepitaxial depositionແລະໃນ etching ສະຖານທີ່, ການນໍາໃຊ້ chlorine-containing silicon gas DCS. ການຄັດເລືອກແມ່ນເນື່ອງມາຈາກການດູດຊຶມຂອງປະລໍາມະນູ Cl ເທິງຫນ້າດິນຊິລິໂຄນແມ່ນຫນ້ອຍກວ່າທີ່ oxides ຫຼື nitrides, ອໍານວຍຄວາມສະດວກໃນການຂະຫຍາຍຕົວ epitaxial. SiH₄, ຂາດປະລໍາມະນູ Cl ແລະມີພະລັງງານການກະຕຸ້ນຕ່ໍາ, ໂດຍທົ່ວໄປແລ້ວຖືກນໍາໃຊ້ກັບຂະບວນການ epitaxy ເຕັມອຸນຫະພູມຕ່ໍາເທົ່ານັ້ນ. ແຫຼ່ງຊິລິໂຄນທີ່ໃຊ້ທົ່ວໄປອີກອັນຫນຶ່ງ, TCS, ມີຄວາມກົດດັນ vapor ຕ່ໍາແລະເປັນຂອງແຫຼວຢູ່ໃນອຸນຫະພູມຫ້ອງ, ຮຽກຮ້ອງໃຫ້ມີການຟອງ H₂ ແນະນໍາມັນເຂົ້າໄປໃນຫ້ອງຕິກິຣິຍາ. ຢ່າງໃດກໍ່ຕາມ, ມັນມີລາຄາບໍ່ແພງແລະມັກຈະຖືກນໍາໃຊ້ສໍາລັບອັດຕາການເຕີບໂຕຢ່າງໄວວາຂອງມັນ (ເຖິງ 5 μm / ນາທີ) ເພື່ອຂະຫຍາຍຊັ້ນຂອງຊິລິໂຄນ epitaxy ຫນາ, ຖືກນໍາໃຊ້ຢ່າງກວ້າງຂວາງໃນການຜະລິດຊິລິໂຄນ epitaxy wafer.
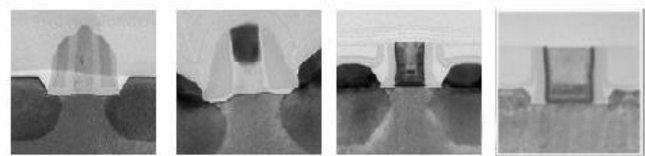
Silicon strained ໃນຊັ້ນ Epitaxial
ໃນລະຫວ່າງການຂະຫຍາຍຕົວ epitaxial, epitaxial single-crystal Si ຖືກຝາກໄວ້ໃນຊັ້ນ SiGe ທີ່ຜ່ອນຄາຍ. ເນື່ອງຈາກການບໍ່ກົງກັນຂອງເສັ້ນດ່າງລະຫວ່າງ Si ແລະ SiGe, ຊັ້ນກະຈົກດຽວ Si ແມ່ນຂຶ້ນກັບຄວາມກົດດັນ tensile ຈາກຊັ້ນ SiGe ທີ່ຕິດພັນ, ເສີມຂະຫຍາຍການເຄື່ອນໄຫວຂອງເອເລັກໂຕຣນິກໃນ NMOS transistors. ເທກໂນໂລຍີນີ້ບໍ່ພຽງແຕ່ເພີ່ມຄວາມອີ່ມຕົວໃນປະຈຸບັນ (Idsat) ແຕ່ຍັງປັບປຸງຄວາມໄວການຕອບສະຫນອງຂອງອຸປະກອນ. ສໍາລັບອຸປະກອນ PMOS, ຊັ້ນ SiGe ແມ່ນການຂະຫຍາຍຕົວທາງດ້ານ epitaxially ໃນແຫຼ່ງແລະພື້ນທີ່ລະບາຍນ້ໍາຫຼັງຈາກ etching ເພື່ອແນະນໍາຄວາມກົດດັນທີ່ບີບອັດຢູ່ໃນຊ່ອງທາງ, ເສີມຂະຫຍາຍການເຄື່ອນທີ່ຂອງຂຸມແລະການເພີ່ມຄວາມອີ່ມຕົວໃນປະຈຸບັນ.
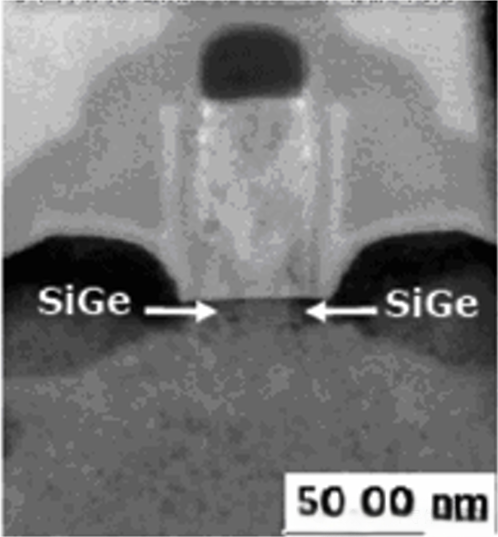
SiGe ເປັນຊັ້ນເສຍສະລະໃນໂຄງສ້າງ GAA
ໃນການຜະລິດຂອງ Gate-All-Around (GAA) transistors nanowire, ຊັ້ນ SiGe ເຮັດຫນ້າທີ່ເປັນຊັ້ນເສຍສະລະ. ເຕັກນິກການ etching anisotropic ທີ່ມີການຄັດເລືອກສູງ, ເຊັ່ນ: ການຂັດຊັ້ນອະຕອມປະລໍາມະນູ (quasi-ALE), ອະນຸຍາດໃຫ້ມີການໂຍກຍ້າຍທີ່ຊັດເຈນຂອງຊັ້ນ SiGe ເພື່ອສ້າງໂຄງສ້າງ nanowire ຫຼື nanosheet.
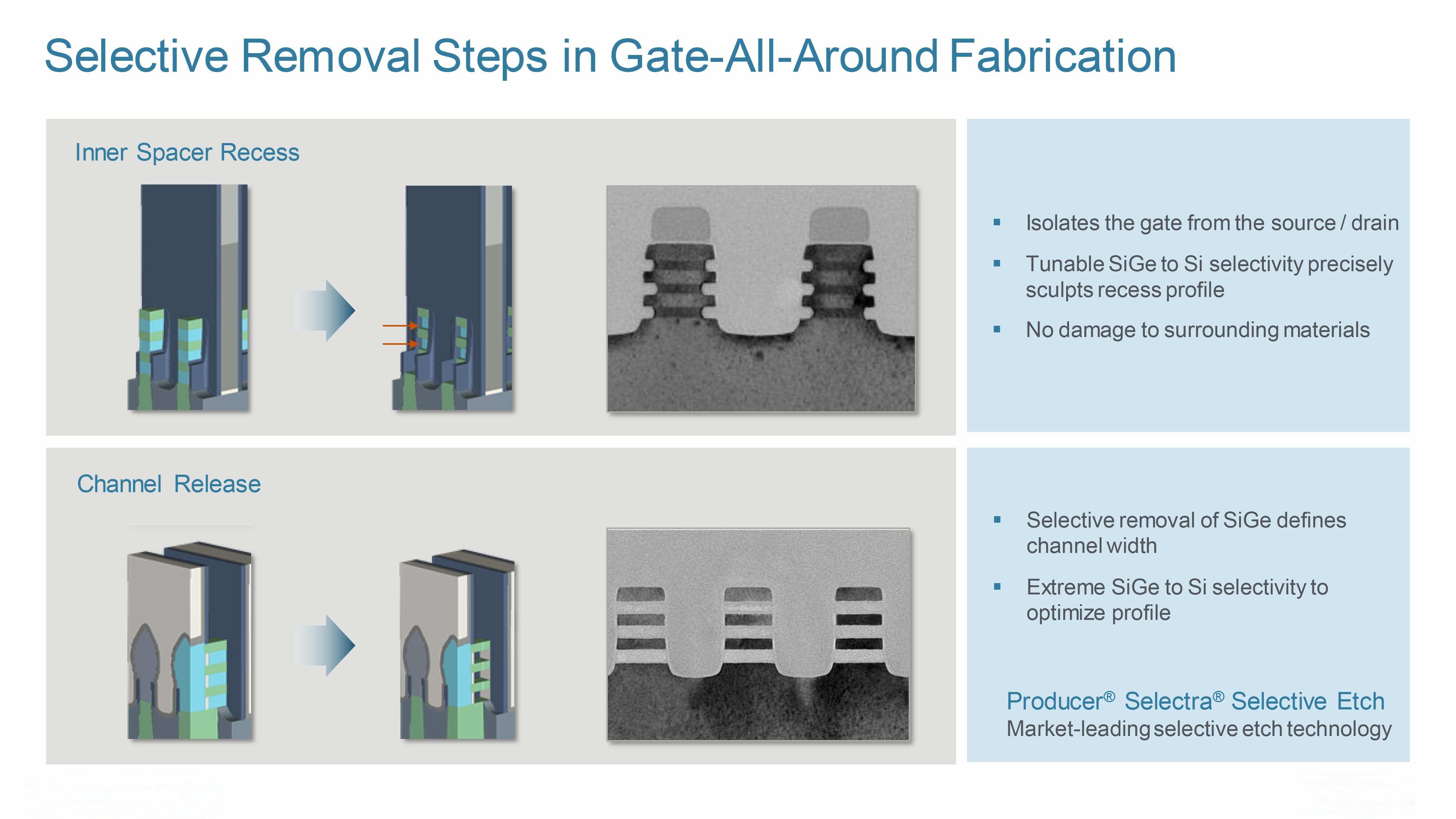
ພວກເຮົາຢູ່ Semicorex ຊ່ຽວຊານໃນSiC/TaC coated graphite solutionsນໍາໃຊ້ໃນການຂະຫຍາຍຕົວ Si epitaxial ໃນການຜະລິດ semiconductor, ຖ້າທ່ານມີຄໍາຖາມຫຼືຕ້ອງການລາຍລະອຽດເພີ່ມເຕີມ, ກະລຸນາຢ່າລັງເລທີ່ຈະຕິດຕໍ່ກັບພວກເຮົາ.
ເບີໂທຕິດຕໍ່: +86-13567891907
ອີເມວ: sales@semicorex.com




