
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ບັນລຸການເຕີບໂຕຂອງ SiC Crystal ຄຸນນະພາບສູງຜ່ານການຄວບຄຸມລະດັບຄວາມສູງຂອງອຸນຫະພູມໃນຂັ້ນຕອນການຂະຫຍາຍຕົວເບື້ອງຕົ້ນ
ແນະນຳ
Silicon carbide (SiC) ແມ່ນວັດສະດຸ semiconductor ກວ້າງ bandgap ທີ່ໄດ້ຮັບຄວາມສົນໃຈຢ່າງຫຼວງຫຼາຍໃນຊຸມປີມໍ່ໆມານີ້ເນື່ອງຈາກປະສິດທິພາບພິເສດຂອງມັນໃນຄໍາຮ້ອງສະຫມັກທີ່ມີແຮງດັນສູງແລະອຸນຫະພູມສູງ. ຄວາມກ້າວຫນ້າຢ່າງໄວວາຂອງວິທີການຂົນສົ່ງທາງກາຍະພາບ Vapor (PVT) ບໍ່ພຽງແຕ່ປັບປຸງຄຸນນະພາບຂອງໄປເຊຍກັນ SiC ດຽວເທົ່ານັ້ນແຕ່ຍັງປະສົບຜົນສໍາເລັດໃນການຜະລິດໄປເຊຍກັນ 150 ມມ SiC. ຢ່າງໃດກໍຕາມ, ຄຸນນະພາບຂອງSiC wafersຍັງຮຽກຮ້ອງໃຫ້ມີການປັບປຸງຕື່ມອີກ, ໂດຍສະເພາະໃນການຫຼຸດຜ່ອນຄວາມຫນາແຫນ້ນຂອງຂໍ້ບົກພ່ອງ. ມັນເປັນທີ່ຮູ້ກັນດີວ່າຂໍ້ບົກພ່ອງຕ່າງໆມີຢູ່ໃນໄປເຊຍກັນ SiC ທີ່ເຕີບໃຫຍ່, ຕົ້ນຕໍແມ່ນຍ້ອນຄວາມເຂົ້າໃຈທີ່ບໍ່ພຽງພໍກ່ຽວກັບກົນໄກການສ້າງຕັ້ງຂໍ້ບົກພ່ອງໃນລະຫວ່າງຂະບວນການເຕີບໂຕຂອງຜລຶກ SiC. ການຄົ້ນຄວ້າໃນຄວາມເລິກຕື່ມອີກກ່ຽວກັບຂະບວນການເຕີບໂຕ PVT ແມ່ນມີຄວາມຈໍາເປັນເພື່ອເພີ່ມເສັ້ນຜ່າກາງແລະຄວາມຍາວຂອງໄປເຊຍກັນ SiC ໃນຂະນະທີ່ຍັງເພີ່ມອັດຕາການຜລຶກ, ດັ່ງນັ້ນການເລັ່ງການຄ້າຂອງອຸປະກອນທີ່ອີງໃສ່ SiC. ເພື່ອບັນລຸການຂະຫຍາຍຕົວໄປເຊຍກັນ SiC ທີ່ມີຄຸນນະພາບສູງ, ພວກເຮົາໄດ້ສຸມໃສ່ການຄວບຄຸມລະດັບອຸນຫະພູມໃນໄລຍະການຂະຫຍາຍຕົວເບື້ອງຕົ້ນ. ເນື່ອງຈາກທາດອາຍແກັສທີ່ອຸດົມສົມບູນຂອງຊິລິໂຄນ (Si, Si2C) ອາດຈະທໍາລາຍຫນ້າດິນຂອງເມັດພືດໃນໄລຍະການຂະຫຍາຍຕົວເບື້ອງຕົ້ນ, ພວກເຮົາໄດ້ສ້າງຕັ້ງລະດັບອຸນຫະພູມທີ່ແຕກຕ່າງກັນໃນຂັ້ນຕອນເບື້ອງຕົ້ນແລະປັບຕົວເຂົ້າກັບເງື່ອນໄຂອຸນຫະພູມອັດຕາສ່ວນ C / Si ຄົງທີ່ໃນລະຫວ່າງຂະບວນການເຕີບໂຕຕົ້ນຕໍ. ການສຶກສານີ້ຂຸດຄົ້ນຢ່າງເປັນລະບົບກ່ຽວກັບຄຸນລັກສະນະຕ່າງໆຂອງໄປເຊຍກັນ SiC ທີ່ປູກໂດຍໃຊ້ເງື່ອນໄຂຂະບວນການດັດແກ້.
ວິທີການທົດລອງ
ການຂະຫຍາຍຕົວຂອງ 6 ນິ້ວ 4H-SiC boules ໄດ້ຖືກປະຕິບັດໂດຍໃຊ້ວິທີການ PVT ໃນ 4° off-axis C- substrates. ເງື່ອນໄຂຂະບວນການປັບປຸງສໍາລັບໄລຍະການຂະຫຍາຍຕົວເບື້ອງຕົ້ນໄດ້ຖືກສະເຫນີ. ອຸນຫະພູມການຂະຫຍາຍຕົວໄດ້ຖືກຕັ້ງໄວ້ລະຫວ່າງ 2300-2400 ° C, ແລະຄວາມກົດດັນໄດ້ຮັບການຮັກສາໄວ້ທີ່ 5-20 Torr, ໃນສະພາບແວດລ້ອມຂອງອາຍແກັສໄນໂຕຣເຈນແລະ argon. 6 ນິ້ວ4H-SiC wafersໄດ້ຖືກຜະລິດໂດຍຜ່ານເຕັກນິກການປຸງແຕ່ງ semiconductor ມາດຕະຖານ. ໄດ້SiC wafersໄດ້ຖືກປຸງແຕ່ງຕາມເງື່ອນໄຂ gradient ອຸນຫະພູມທີ່ແຕກຕ່າງກັນໃນໄລຍະການຂະຫຍາຍຕົວເບື້ອງຕົ້ນແລະ etched ທີ່ 600 ° C ສໍາລັບ 14 ນາທີເພື່ອປະເມີນຂໍ້ບົກຜ່ອງ. ຄວາມຫນາແຫນ້ນຂອງຂຸມ etch (EPD) ຂອງຫນ້າດິນໄດ້ຖືກວັດແທກໂດຍໃຊ້ກ້ອງຈຸລະທັດ optical (OM). ຄວາມກວ້າງເຕັມທີ່ຄ່າສູງສຸດເຄິ່ງຫນຶ່ງ (FWHM) ແລະຮູບພາບແຜນທີ່ຂອງwafers SiC 6 ນິ້ວໄດ້ຖືກວັດແທກໂດຍໃຊ້ລະບົບການແຜ່ກະຈາຍ X-ray ທີ່ມີຄວາມລະອຽດສູງ (XRD).
ຜົນໄດ້ຮັບແລະການສົນທະນາ

ຮູບທີ 1: Schematic ຂອງ SiC Crystal Growth Mechanism
ເພື່ອບັນລຸການຈະເລີນເຕີບໂຕໄປເຊຍກັນ SiC ທີ່ມີຄຸນນະພາບສູງ, ໂດຍທົ່ວໄປແລ້ວມັນຈໍາເປັນຕ້ອງໃຊ້ແຫຼ່ງຜົງ SiC ທີ່ມີຄວາມບໍລິສຸດສູງ, ຄວບຄຸມອັດຕາສ່ວນ C / Si ຢ່າງແນ່ນອນ, ແລະຮັກສາອຸນຫະພູມແລະຄວາມກົດດັນທີ່ຄົງທີ່. ນອກຈາກນັ້ນ, ການຫຼຸດຜ່ອນການສູນເສຍໄປເຊຍກັນຂອງເມັດແລະສະກັດກັ້ນການເກີດຄວາມຜິດປົກກະຕິຂອງຫນ້າດິນຂອງເມັດເມັດໃນໄລຍະການຂະຫຍາຍຕົວເບື້ອງຕົ້ນແມ່ນສໍາຄັນ. ຮູບທີ 1 ສະແດງໃຫ້ເຫັນແຜນຜັງຂອງກົນໄກການເຕີບໂຕຂອງຜລຶກ SiC ໃນການສຶກສານີ້. ດັ່ງທີ່ສະແດງຢູ່ໃນຮູບທີ 1, ອາຍແກັສ vapor (ST) ຖືກສົ່ງໄປຫາຫນ້າຜລຶກຂອງເມັດ, ບ່ອນທີ່ພວກມັນກະຈາຍແລະປະກອບເປັນໄປເຊຍກັນ. ທາດອາຍຜິດບາງຢ່າງທີ່ບໍ່ມີສ່ວນຮ່ວມໃນການເຕີບໂຕ (ST) desorb ຈາກຫນ້າດິນໄປເຊຍກັນ. ເມື່ອປະລິມານອາຍແກັສເທິງຫນ້າດິນຂອງເມັດເມັດ (SG) ເກີນອາຍແກັສ desorbed (SD), ຂະບວນການຂະຫຍາຍຕົວ. ດັ່ງນັ້ນ, ອັດຕາສ່ວນອາຍແກັສ (SG) / ອາຍແກັສ (SD) ທີ່ເຫມາະສົມໃນລະຫວ່າງຂະບວນການເຕີບໂຕໄດ້ຖືກສຶກສາໂດຍການປ່ຽນຕໍາແຫນ່ງຂອງທໍ່ຄວາມຮ້ອນ RF.
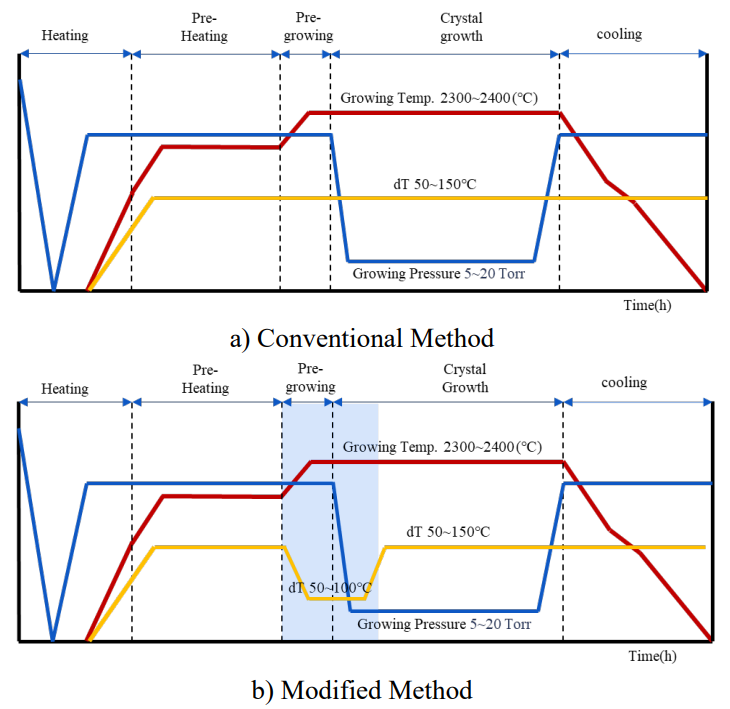
ຮູບທີ 2: Schematic ຂອງ SiC Crystal Growth ເງື່ອນໄຂ
ຮູບ 2 ສະແດງໃຫ້ເຫັນ schematic ຂອງຂະບວນການການຂະຫຍາຍຕົວໄປເຊຍກັນ SiC ໃນການສຶກສານີ້. ອຸນຫະພູມຂະບວນການຂະຫຍາຍຕົວປົກກະຕິຢູ່ລະຫວ່າງ 2300 ຫາ 2400 ° C, ຄວາມກົດດັນຮັກສາຢູ່ທີ່ 5 ຫາ 20 Torr. ໃນລະຫວ່າງຂະບວນການຂະຫຍາຍຕົວ, gradient ອຸນຫະພູມແມ່ນຮັກສາໄວ້ທີ່ dT = 50 ~ 150 ° C ((a) ວິທີການທໍາມະດາ). ບາງຄັ້ງ, ການສະຫນອງອາຍແກັສແຫຼ່ງທີ່ບໍ່ສະເຫມີກັນ (Si2C, SiC2, Si) ອາດຈະເຮັດໃຫ້ເກີດຄວາມຜິດ stacking, ການລວມເອົາ polytype, ແລະດັ່ງນັ້ນຈຶ່ງເຮັດໃຫ້ຄຸນນະພາບຂອງໄປເຊຍກັນຫຼຸດລົງ. ດັ່ງນັ້ນ, ໃນໄລຍະການຂະຫຍາຍຕົວໃນເບື້ອງຕົ້ນ, ໂດຍການປ່ຽນແປງຕໍາແຫນ່ງຂອງ coil RF, dT ໄດ້ຖືກຄວບຄຸມຢ່າງລະມັດລະວັງພາຍໃນ 50 ~ 100 ° C, ຫຼັງຈາກນັ້ນປັບເປັນ dT = 50 ~ 150 ° C ໃນລະຫວ່າງຂະບວນການເຕີບໂຕຕົ້ນຕໍ ((b) ວິທີການປັບປຸງ) . ເພື່ອຄວບຄຸມລະດັບອຸນຫະພູມ (dT[°C] = Tbottom-Tupper), ອຸນຫະພູມລຸ່ມໄດ້ຖືກແກ້ໄຂຢູ່ທີ່ 2300 ° C, ແລະອຸນຫະພູມເທິງໄດ້ຖືກປັບຈາກ 2270 ° C, 2250 ° C, 2200 ° C ຫາ 2150 ° C. ຕາຕະລາງ 1 ສະເໜີພາບກ້ອງຈຸລະທັດທາງແສງ (OM) ຂອງພື້ນຜິວ SiC boule ຂະຫຍາຍຕົວພາຍໃຕ້ເງື່ອນໄຂ gradient ອຸນຫະພູມທີ່ແຕກຕ່າງກັນຫຼັງຈາກ 10 ຊົ່ວໂມງ.
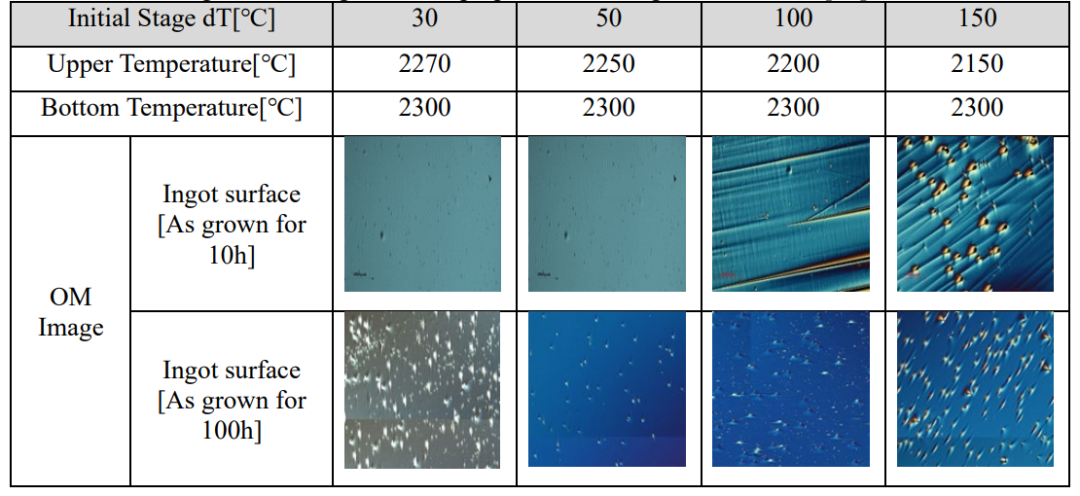
ຕາຕະລາງ 1: Optical Microscope (OM) ຮູບພາບຂອງ SiC Boule Surface Grown ສໍາລັບ 10 ຊົ່ວໂມງແລະ 100 ຊົ່ວໂມງພາຍໃຕ້ເງື່ອນໄຂ Gradient ອຸນຫະພູມທີ່ແຕກຕ່າງກັນ
ຢູ່ທີ່ dT = 50 ° C, ຄວາມຫນາແຫນ້ນຂອງຂໍ້ບົກພ່ອງໃນພື້ນຜິວ boule SiC ຫຼັງຈາກການຂະຫຍາຍຕົວ 10 ຊົ່ວໂມງແມ່ນຕໍ່າກວ່າຢ່າງຫຼວງຫຼາຍພາຍໃຕ້ dT = 30 ° C ແລະ dT = 150 ° C. ຢູ່ທີ່ dT = 30 ° C, gradient ອຸນຫະພູມເບື້ອງຕົ້ນອາດຈະນ້ອຍເກີນໄປ, ເຮັດໃຫ້ເກີດການສູນເສຍໄປເຊຍກັນຂອງເມັດແລະການສ້າງຜິດປົກກະຕິ. ໃນທາງກົງກັນຂ້າມ, ຢູ່ທີ່ລະດັບຄວາມເຂັ້ມຂຸ້ນຂອງອຸນຫະພູມເບື້ອງຕົ້ນທີ່ສູງກວ່າ (dT=150°C), ສະພາບຄວາມອີ່ມຕົວທີ່ບໍ່ຄົງທີ່ອາດຈະເກີດຂຶ້ນ, ເຮັດໃຫ້ເກີດການລວມຕົວຂອງ polytype ແລະຂໍ້ບົກພ່ອງເນື່ອງຈາກຄວາມເຂັ້ມຂຸ້ນສູງ. ຢ່າງໃດກໍຕາມ, ຖ້າຫາກວ່າ gradient ອຸນຫະພູມເບື້ອງຕົ້ນແມ່ນ optimized, ການຂະຫຍາຍຕົວໄປເຊຍກັນຄຸນນະພາບສູງສາມາດບັນລຸໄດ້ໂດຍການຫຼຸດຜ່ອນການສ້າງຕັ້ງຂອງຂໍ້ບົກພ່ອງເບື້ອງຕົ້ນ. ເນື່ອງຈາກຄວາມຫນາແຫນ້ນຂອງຂໍ້ບົກພ່ອງໃນຫນ້າດິນ boule SiC ຫຼັງຈາກ 100 ຊົ່ວໂມງຂອງການຂະຫຍາຍຕົວແມ່ນຄ້າຍຄືກັນກັບຜົນໄດ້ຮັບຫຼັງຈາກ 10 ຊົ່ວໂມງ, ການຫຼຸດຜ່ອນການສ້າງຂໍ້ບົກພ່ອງໃນໄລຍະການຂະຫຍາຍຕົວເບື້ອງຕົ້ນແມ່ນຂັ້ນຕອນທີ່ສໍາຄັນໃນການໄດ້ຮັບໄປເຊຍກັນ SiC ທີ່ມີຄຸນນະພາບສູງ.
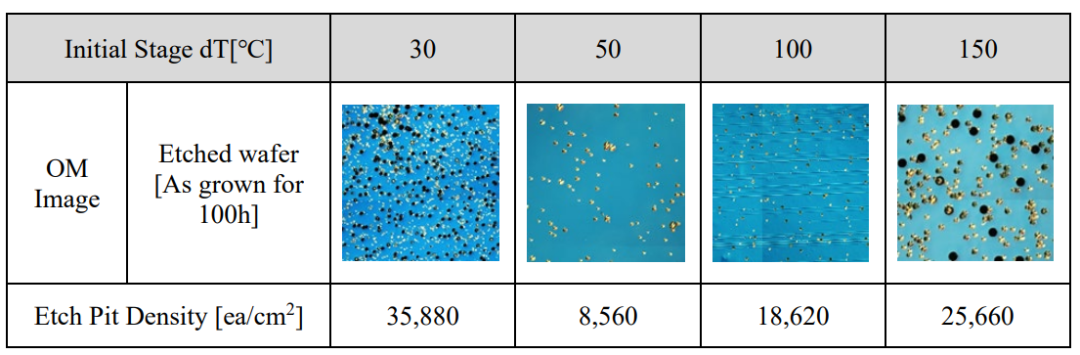
ຕາຕະລາງ 2: ຄ່າ EPD ຂອງ Etched Boules SiC ພາຍໃຕ້ເງື່ອນໄຂການປັບສີຂອງອຸນຫະພູມທີ່ແຕກຕ່າງກັນ
Wafersການກະກຽມຈາກ boules ທີ່ປູກສໍາລັບ 100 ຊົ່ວໂມງໄດ້ຖືກ etched ເພື່ອສຶກສາຄວາມຫນາແຫນ້ນຂອງຂໍ້ບົກພ່ອງຂອງໄປເຊຍກັນ SiC, ດັ່ງທີ່ສະແດງຢູ່ໃນຕາຕະລາງ 2. ຄ່າ EPD ຂອງໄປເຊຍກັນ SiC ທີ່ປູກພາຍໃຕ້ເບື້ອງຕົ້ນ dT = 30 ° C ແລະ dT = 150 ° C ແມ່ນ 35,880 / cm² ແລະ 25,660. /cm², ຕາມລໍາດັບ, ໃນຂະນະທີ່ຄ່າ EPD ຂອງໄປເຊຍກັນ SiC ທີ່ເຕີບໂຕພາຍໃຕ້ເງື່ອນໄຂທີ່ດີທີ່ສຸດ (dT = 50 ° C) ຫຼຸດລົງຢ່າງຫຼວງຫຼາຍເຖິງ 8,560 / cm².
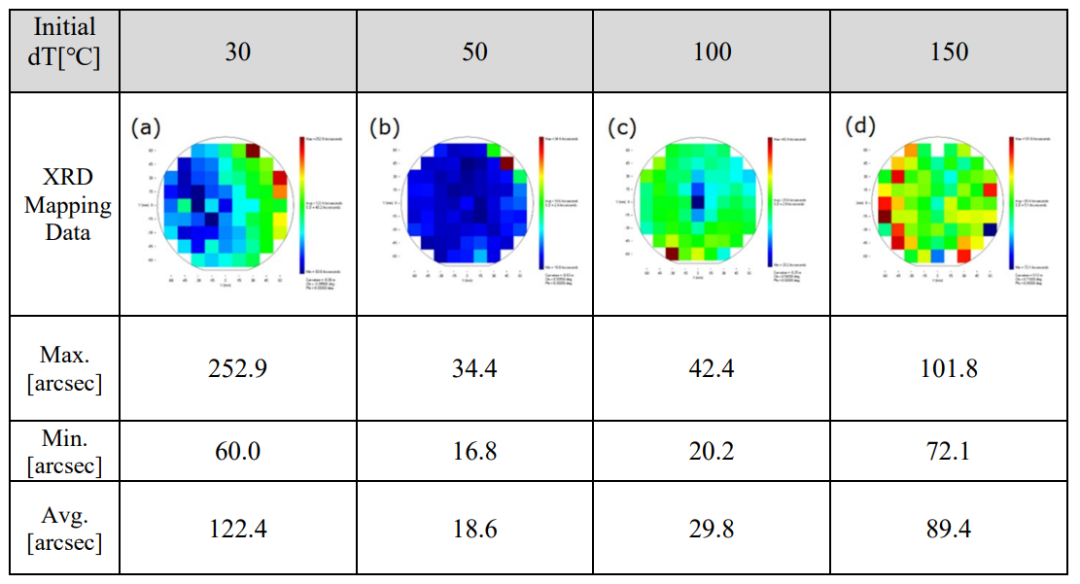
ຕາຕະລາງ 3: ຄ່າ FWHM ແລະ XRD Mapping ຮູບພາບຂອງ SiC Crystals ພາຍໃຕ້ເງື່ອນໄຂ Gradient ອຸນຫະພູມເບື້ອງຕົ້ນທີ່ແຕກຕ່າງກັນ
ຕາຕະລາງ 3 ນໍາສະເຫນີຄ່າ FWHM ແລະຮູບພາບແຜນທີ່ XRD ຂອງໄປເຊຍກັນ SiC ທີ່ເຕີບໂຕພາຍໃຕ້ເງື່ອນໄຂການ gradient ອຸນຫະພູມເບື້ອງຕົ້ນທີ່ແຕກຕ່າງກັນ. ມູນຄ່າ FWHM ສະເລ່ຍຂອງໄປເຊຍກັນ SiC ທີ່ປູກພາຍໃຕ້ເງື່ອນໄຂທີ່ດີທີ່ສຸດ (dT=50°C) ແມ່ນ 18.6 arcseconds, ຕໍ່າກວ່າຂອງໄປເຊຍກັນ SiC ທີ່ເຕີບໂຕພາຍໃຕ້ເງື່ອນໄຂການປັບສີຂອງອຸນຫະພູມອື່ນໆ.
ສະຫຼຸບ
ຜົນກະທົບຂອງການ gradient ອຸນຫະພູມໃນໄລຍະການຂະຫຍາຍຕົວໃນເບື້ອງຕົ້ນກ່ຽວກັບຄຸນນະພາບໄປເຊຍກັນ SiC ໄດ້ສຶກສາໂດຍການຄວບຄຸມ gradient ອຸນຫະພູມ (dT[°C] = Tbottom-Tupper) ໂດຍການປ່ຽນແປງຕໍາແຫນ່ງຂອງມ້ວນ. ຜົນໄດ້ຮັບສະແດງໃຫ້ເຫັນວ່າຄວາມຫນາແຫນ້ນຂອງຂໍ້ບົກພ່ອງໃນພື້ນຜິວ boule SiC ຫຼັງຈາກ 10 ຊົ່ວໂມງຂອງການຂະຫຍາຍຕົວພາຍໃຕ້ເງື່ອນໄຂເບື້ອງຕົ້ນ dT = 50 ° C ແມ່ນຕໍ່າກວ່າຢ່າງຫຼວງຫຼາຍພາຍໃຕ້ dT = 30 ° C ແລະ dT = 150 ° C. ມູນຄ່າ FWHM ສະເລ່ຍຂອງໄປເຊຍກັນ SiC ຂະຫຍາຍຕົວພາຍໃຕ້ເງື່ອນໄຂທີ່ດີທີ່ສຸດ (dT = 50 ° C) ແມ່ນ 18.6 arcseconds, ຕ່ໍາກວ່າຢ່າງຫຼວງຫຼາຍຂອງໄປເຊຍກັນ SiC ຂະຫຍາຍຕົວພາຍໃຕ້ເງື່ອນໄຂອື່ນໆ. ນີ້ຊີ້ໃຫ້ເຫັນວ່າການເພີ່ມປະສິດທິພາບການປັບລະດັບອຸນຫະພູມເບື້ອງຕົ້ນຢ່າງມີປະສິດທິພາບຫຼຸດຜ່ອນການສ້າງຕັ້ງຂອງຂໍ້ບົກພ່ອງເບື້ອງຕົ້ນ, ດັ່ງນັ້ນຈຶ່ງບັນລຸການເຕີບໂຕຂອງຜລຶກ SiC ທີ່ມີຄຸນນະພາບສູງ.**




