
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ການຜະລິດຊິບ: ຂະບວນການຟິມບາງ
ການແນະນໍາພື້ນຖານກ່ຽວກັບຂະບວນການຟິມບາງແມ່ນຫຍັງ?
ຂະບວນການປ່ອຍຮູບເງົາບາງໆ semiconductor ແມ່ນອົງປະກອບທີ່ສໍາຄັນຂອງເຕັກໂນໂລຢີຈຸນລະພາກທີ່ທັນສະໄຫມ. ມັນກ່ຽວຂ້ອງກັບການກໍ່ສ້າງວົງຈອນປະສົມປະສານທີ່ສັບສົນໂດຍການຝາກຊັ້ນບາງໆຫຼືຫຼາຍຊັ້ນຂອງວັດສະດຸໃສ່ substrate semiconductor. ຮູບເງົາບາງໆເຫຼົ່ານີ້ສາມາດເປັນໂລຫະ, insulators, ຫຼືວັດສະດຸ semiconductor, ແຕ່ລະຄົນມີບົດບາດທີ່ແຕກຕ່າງກັນໃນຊັ້ນຕ່າງໆຂອງ chip, ເຊັ່ນ conduction, insulation, ແລະການປ້ອງກັນ. ຄຸນນະພາບຂອງຮູບເງົາບາງໆເຫຼົ່ານີ້ມີຜົນກະທົບໂດຍກົງຕໍ່ການປະຕິບັດ, ຄວາມຫນ້າເຊື່ອຖື, ແລະຄ່າໃຊ້ຈ່າຍຂອງຊິບ. ດັ່ງນັ້ນ, ການພັດທະນາເທກໂນໂລຍີການຊຶມເຊື້ອຂອງຮູບເງົາບາງໆແມ່ນມີຄວາມສໍາຄັນທີ່ສໍາຄັນຕໍ່ອຸດສາຫະກໍາ semiconductor.

ຂະບວນການຮູບເງົາບາງຖືກຈັດປະເພດແນວໃດ?
ປະຈຸບັນ, ອຸປະກອນແລະເຕັກນິກການລະບາຍຟິມບາງໆຕົ້ນຕໍລວມມີການຕົກຄ້າງຂອງອາຍພິດທາງກາຍະພາບ (PVD), ການຕົກຄ້າງຂອງອາຍພິດທາງເຄມີ (CVD), ແລະການຕົກຄ້າງຂອງຊັ້ນປະລໍາມະນູ (ALD). ເຕັກນິກສາມຢ່າງນີ້ມີຄວາມແຕກຕ່າງກັນຢ່າງຈະແຈ້ງໃນຫຼັກການການຝາກ, ວັດສະດຸ, ຊັ້ນຮູບເງົາທີ່ໃຊ້ໄດ້, ແລະຂະບວນການ.
1. ການປ່ອຍອາຍພິດທາງກາຍ (PVD)
ການຖິ້ມອາຍຂອງອາຍທາງກາຍ (PVD) ແມ່ນຂະບວນການທາງກາຍະພາບທີ່ບໍລິສຸດທີ່ວັດສະດຸຖືກລະເຫີຍໂດຍການລະເຫີຍຫຼື sputtering ແລະຫຼັງຈາກນັ້ນ condensed ສຸດ substrate ເພື່ອສ້າງເປັນຮູບເງົາບາງໆ.
ການລະເຫີຍສູນຍາກາດ: ວັດສະດຸຖືກເຮັດໃຫ້ຄວາມຮ້ອນເປັນໄອພາຍໃຕ້ສະພາບສູນຍາກາດສູງ ແລະຝາກລົງໃສ່ແຜ່ນຮອງ.
Sputtering: ອາຍແກັສທີ່ເກີດຈາກການປ່ອຍອາຍແກັສຖິ້ມລະເບີດໃສ່ວັດຖຸເປົ້າໝາຍດ້ວຍຄວາມໄວສູງ, ເຮັດໃຫ້ປະລໍາມະນູ dislodging ປະກອບເປັນຮູບເງົາກ່ຽວກັບ substrate ໄດ້.
Ion Plating: ສົມທົບຂໍ້ໄດ້ປຽບຂອງການລະເຫີຍສູນຍາກາດແລະ sputtering, ບ່ອນທີ່ອຸປະກອນການ vaporized ແມ່ນ ionized ບາງສ່ວນໃນຊ່ອງລະບາຍແລະດຶງດູດການ substrate ເພື່ອສ້າງເປັນຮູບເງົາ.
ລັກສະນະ: PVD ກ່ຽວຂ້ອງກັບການປ່ຽນແປງທາງດ້ານຮ່າງກາຍເທົ່ານັ້ນທີ່ບໍ່ມີປະຕິກິລິຍາທາງເຄມີ.
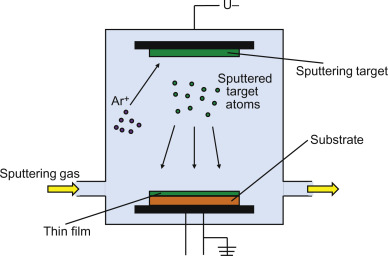
2. ການປ່ອຍອາຍພິດທາງເຄມີ (CVD)
Chemical Vapor Deposition (CVD) ແມ່ນເຕັກນິກທີ່ປະກອບດ້ວຍປະຕິກິລິຍາເຄມີໄລຍະແກັສເພື່ອສ້າງເປັນຮູບເງົາບາງໆແຂງຢູ່ເທິງຊັ້ນຍ່ອຍ.
CVD ທໍາມະດາ: ເຫມາະສໍາລັບການຝາກຮູບເງົາ dielectric ແລະ semiconductor ຕ່າງໆ.
Plasma-Enhanced CVD (PECVD): ໃຊ້ plasma ເພື່ອເພີ່ມກິດຈະກໍາຕິກິຣິຍາ, ເຫມາະສົມສໍາລັບການຊຶມເຊື້ອໃນອຸນຫະພູມຕ່ໍາ.
High-Density Plasma CVD (HDPCVD): ອະນຸຍາດໃຫ້ມີການຊຶມເຊື້ອ ແລະ ຮອຍຂີດຂ່ວນພ້ອມໆກັນ, ສະເຫນີຄວາມສາມາດໃນການຕື່ມຊ່ອງຫວ່າງທີ່ມີອັດຕາສ່ວນສູງທີ່ດີເລີດ.
Sub-Atmospheric CVD (SACVD): ບັນລຸຄວາມສາມາດໃນການຕື່ມຂໍ້ມູນຂຸມທີ່ດີເລີດພາຍໃຕ້ເງື່ອນໄຂທີ່ມີຄວາມກົດດັນສູງໂດຍການນໍາໃຊ້ສານຕ້ານອະນຸມູນອິດສະລະອົກຊີເຈນທີ່ມີປະຕິກິລິຍາສູງທີ່ສ້າງຂຶ້ນໃນອຸນຫະພູມສູງ.
Metal-Organic CVD (MOCVD): ເຫມາະສໍາລັບວັດສະດຸ semiconductor ເຊັ່ນ GaN.
ຄຸນລັກສະນະ: CVD ປະກອບດ້ວຍທາດປະຕິກອນໄລຍະແກັສເຊັ່ນ silane, phosphine, borane, ammonia, ແລະອົກຊີ, ການຜະລິດຮູບເງົາແຂງເຊັ່ນ nitrides, oxides, oxynitrides, carbides, ແລະ polysilicon ພາຍໃຕ້ອຸນຫະພູມສູງ, ຄວາມກົດດັນສູງ, ຫຼື plasma ເງື່ອນໄຂ.
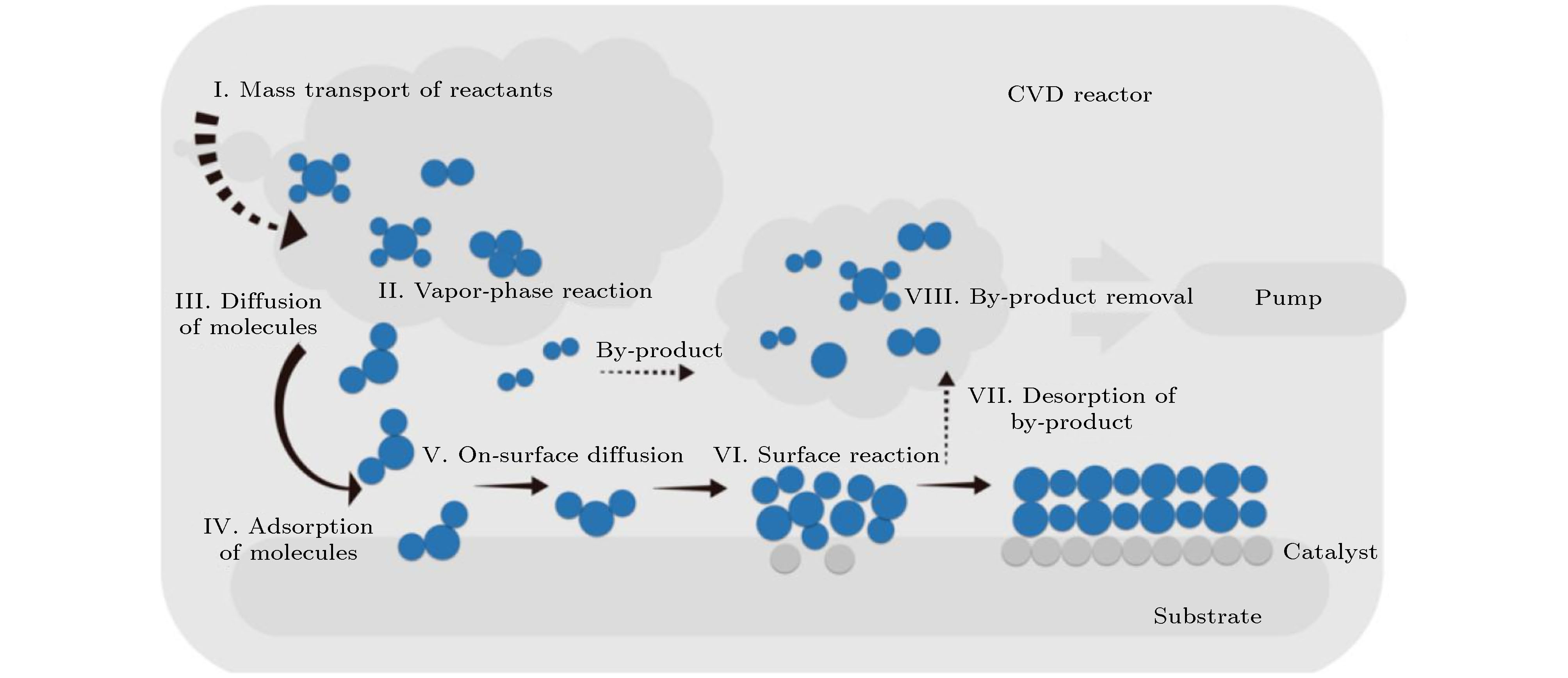
3. ການວາງຊັ້ນອະຕອມ (ALD)
Atomic Layer Deposition (ALD) ແມ່ນເຕັກນິກ CVD ພິເສດທີ່ກ່ຽວຂ້ອງກັບການນໍາສະຫຼັບຂອງກໍາມະຈອນເຕັ້ນຂອງ reactants ສອງຫຼືຫຼາຍກວ່ານັ້ນ, ບັນລຸການປະລໍາມະນູຊັ້ນດຽວທີ່ຊັດເຈນ.
Thermal ALD (TALD): ໃຊ້ພະລັງງານຄວາມຮ້ອນສໍາລັບການດູດຊຶມຂອງຄາຣະວາແລະປະຕິກິລິຍາເຄມີຕໍ່ໆມາຢູ່ເທິງຊັ້ນໃຕ້ດິນ.
Plasma-Enhanced ALD (PEALD): ໃຊ້ plasma ເພື່ອເພີ່ມກິດຈະກໍາປະຕິກິລິຢາ, ຊ່ວຍໃຫ້ອັດຕາການຊຶມເຊື້ອໄວຂຶ້ນໃນອຸນຫະພູມຕ່ໍາ.
ຄຸນລັກສະນະ: ALD ສະຫນອງການຄວບຄຸມຄວາມຫນາຂອງຟິມທີ່ຊັດເຈນ, ຄວາມສອດຄ່ອງທີ່ດີເລີດ, ແລະຄວາມສອດຄ່ອງ, ເຮັດໃຫ້ມັນເຫມາະສົມສໍາລັບການເຕີບໂຕຂອງຮູບເງົາໃນໂຄງສ້າງຂອງທໍ່ເລິກ.
ຂະບວນການຟິມບາງໆຖືກນຳໃຊ້ແນວໃດໃນຊິບ?
ຊັ້ນໂລຫະ: PVD ຕົ້ນຕໍແມ່ນໃຊ້ສໍາລັບການຝາກໂລຫະທີ່ບໍລິສຸດແລະແຜ່ນໂລຫະ nitride ຫັນປ່ຽນ, ເຊັ່ນ: ແຜ່ນອາລູມິນຽມ, ຫນ້າກາກໂລຫະແຂງ, ຊັ້ນອຸປະສັກທອງແດງ, ແລະຊັ້ນເມັດທອງແດງ.
Al pad: ແຜ່ນຜູກມັດສໍາລັບ PCBs.
Metal Hard Mask: TiN ທົ່ວໄປ, ໃຊ້ໃນ photolithography.
Cu Barrier Layer: ເລື້ອຍໆ TaN, ປ້ອງກັນບໍ່ໃຫ້ Cu ການແຜ່ກະຈາຍ.
ຊັ້ນເມັດພັນ Cu: ໂລຫະປະສົມ Cu ຫຼື Cu ບໍລິສຸດ, ໃຊ້ເປັນຊັ້ນແກ່ນສໍາລັບການໃສ່ໄຟຟ້າໃນພາຍຫລັງ.
Dielectric Layers: CVD ສ່ວນໃຫຍ່ແມ່ນໃຊ້ສໍາລັບການຝາກວັດສະດຸ insulating ຕ່າງໆເຊັ່ນ nitrides, oxides, oxynitrides, carbides, ແລະ polysilicon, ເຊິ່ງແຍກອົງປະກອບວົງຈອນທີ່ແຕກຕ່າງກັນແລະຫຼຸດຜ່ອນການແຊກແຊງ.
Gate Oxide Layer: isolates ປະຕູຮົ້ວແລະຊ່ອງທາງ.
Interlayer Dielectric: ແຍກຊັ້ນໂລຫະທີ່ແຕກຕ່າງກັນ.
ຊັ້ນສິ່ງກີດຂວາງ: PVD ຖືກນໍາໃຊ້ເພື່ອປ້ອງກັນການແຜ່ກະຈາຍຂອງໂລຫະແລະປ້ອງກັນອຸປະກອນຈາກການປົນເປື້ອນ.
Cu Barrier Layer: ປ້ອງກັນການແຜ່ກະຈາຍຂອງທອງແດງ, ຮັບປະກັນການປະຕິບັດອຸປະກອນ.
Hard Masks: PVD ຖືກນໍາໃຊ້ໃນ photolithography ເພື່ອຊ່ວຍກໍານົດໂຄງສ້າງອຸປະກອນ.
Metal Hard Mask: TiN ທົ່ວໄປ, ໃຊ້ເພື່ອກໍານົດຮູບແບບຕ່າງໆ.
ການຈັດວາງແບບຄູ່ດ້ວຍຕົນເອງ (SADP): ALD ໃຊ້ຊັ້ນ spacer ສໍາລັບຮູບແບບລະອຽດກວ່າ, ເຫມາະສົມສໍາລັບການຜະລິດໂຄງສ້າງ Fin ໃນ FinFETs.
FinFET: ໃຊ້ຊັ້ນ spacer ເພື່ອສ້າງຫນ້າກາກແຂງຢູ່ແຄມຂອງຮູບແບບຫຼັກ, ບັນລຸການຄູນຄວາມຖີ່ທາງກວ້າງຂອງພື້ນ.
High-K Metal Gate (HKMG): ALD ຖືກນໍາໃຊ້ເພື່ອຝາກວັດສະດຸຄົງທີ່ dielectric ສູງແລະປະຕູໂລຫະ, ປັບປຸງການປະຕິບັດຂອງ transistor, ໂດຍສະເພາະໃນຂະບວນການ 28nm ແລະຕ່ໍາກວ່າ.
High-K Dielectric Layer: HfO2 ແມ່ນທາງເລືອກທົ່ວໄປທີ່ສຸດ, ໂດຍ ALD ເປັນວິທີການກະກຽມທີ່ຕ້ອງການ.
ປະຕູໂລຫະ: ພັດທະນາເນື່ອງຈາກຄວາມເຂົ້າກັນບໍ່ໄດ້ຂອງອົງປະກອບ Hf ກັບປະຕູ polysilicon.
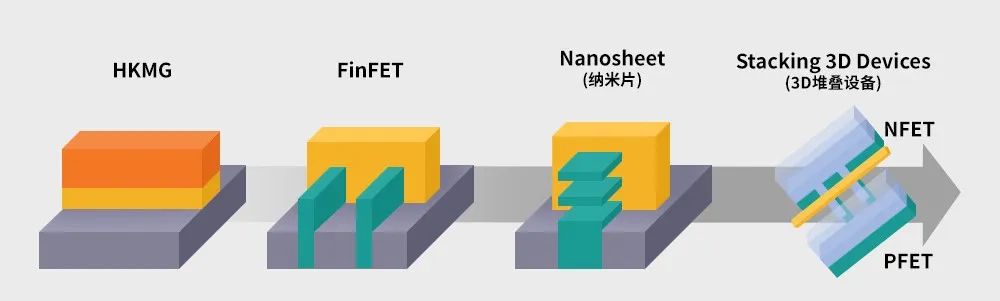
ຄໍາຮ້ອງສະຫມັກອື່ນໆ: ALD ຍັງຖືກນໍາໃຊ້ຢ່າງກວ້າງຂວາງໃນຊັ້ນອຸປະສັກການແຜ່ກະຈາຍຂອງທອງແດງແລະເຕັກໂນໂລຢີອື່ນໆ.
Copper Interconnect Diffusion Barrier Layer: ປ້ອງກັນການແຜ່ກະຈາຍຂອງທອງແດງ, ປົກປ້ອງປະສິດທິພາບຂອງອຸປະກອນ.
ຈາກການແນະນໍາຂ້າງເທິງ, ພວກເຮົາສາມາດສັງເກດເຫັນວ່າ PVD, CVD, ແລະ ALD ມີລັກສະນະພິເສດແລະຄວາມໄດ້ປຽບ, ມີບົດບາດ irreplaceable ໃນການຜະລິດ semiconductor. PVD ສ່ວນໃຫຍ່ແມ່ນໃຊ້ສໍາລັບການຫລໍ່ຫລອມໂລຫະ, CVD ແມ່ນເຫມາະສົມສໍາລັບການຝາກຮູບເງົາ dielectric ແລະ semiconductor ຕ່າງໆ, ໃນຂະນະທີ່ ALD ດີເລີດໃນຂະບວນການທີ່ກ້າວຫນ້າດ້ວຍການຄວບຄຸມຄວາມຫນາແຫນ້ນແລະຄວາມສາມາດໃນການຄຸ້ມຄອງຂັ້ນຕອນ. ການພັດທະນາຢ່າງຕໍ່ເນື່ອງແລະການປັບປຸງໃຫມ່ຂອງເຕັກໂນໂລຢີເຫຼົ່ານີ້ເຮັດໃຫ້ພື້ນຖານອັນຫນັກແຫນ້ນສໍາລັບຄວາມກ້າວຫນ້າຂອງອຸດສາຫະກໍາ semiconductor.**
ພວກເຮົາຢູ່ Semicorex ຊ່ຽວຊານໃນອົງປະກອບການເຄືອບ CVD SiC/TaCນໍາໃຊ້ໃນການຜະລິດ semiconductor, ຖ້າທ່ານມີຄໍາຖາມໃດໆຫຼືຕ້ອງການລາຍລະອຽດເພີ່ມເຕີມ, ກະລຸນາຢ່າລັງເລທີ່ຈະຕິດຕໍ່ກັບພວກເຮົາ.
ເບີໂທຕິດຕໍ່: +86-13567891907
ອີເມວ: sales@semicorex.com




